C&C 사업부는 반도체 제조 현장에서 발생되는 파티클 (이물 미립자), 금속 불순물, 표면 흡착화학4물질 등의 미세한 오염 물질이 반도체 제품의 수율과 신뢰성을 떨어트리는 것을 방지하기 위하여 300mm 실리콘 웨이퍼 양면으로부터 이들의 오염물질을 제거하기 위한 다양한 공정을 탑재한 세정 장치를 공급하고 있습니다.
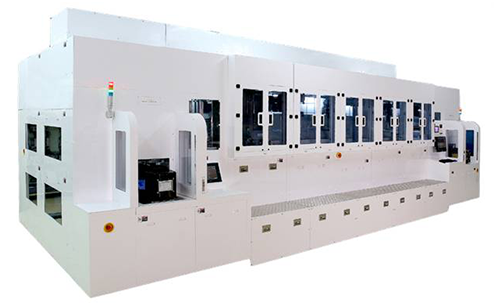
300mm "Wezen BF" (Front Type)

300mm "Wezen BS" (Ⅰ Type)
침적식 세정 장치로 25~50매의 Wafer를 다수의 세정조에 침적하여 각각의 약액 처리 후 순수로 세척한 뒤 Hot IPA를 이용하여 건조하는 방식의 장비입니다. 케이씨텍 Batch 세정장치는 Wafer Flow에 따라 Front Type과 Ⅰ Type으로 구분돼 공정 Line의 공간 배치에 유동적으로 대응 가능합니다.
Particle Performance
· SC1 Last Clean : ≤ 10ea, HF Last Clean : ≤ 30ea
· Rinse only : ≤ 10ea, FRD : ≤ 30ea
Dryer Performance
· Water Mark Free (@IPA Bubble with Hot Function)
Etch Rate Uniformity
· With in Wafer/Wafer to Wafer : ≤ 3%
(Using Thermal Oxide Wafer)
Throughput
· Chemical + RD : > 450wfs/hr(@Front Type)
· CHemical + FRD : > 350wfs/hr(@3FRD)
Metallic Contamination
· K, Ca, Cr, Fe, Zn, Mn, Ni, Cu : < 0.5E10 atoms/cm2

K-3000
Wafer 1매마다 세밀한 프로세스 관리를 위해 8개, 12개의 개별 Chamber에서 약액 처리, Rinse, Dry의 공정을 진행하는 장비입니다. 사이클 타임의 단축, Wet Etching시 면내 균일성을 높이며, 약액·세정시퀀스의 변경과 추가가 용이하여 공정의 자유도가 높고, 세정/건조 후의 시간을 두지 않고 연속 처리가 가능하여 오염 부착과 자연 산화막 성장을 방지할 수 있다는 장점을 갖고 있습니다.
Application
· Polymer Removal, Film Etch, Pre Clean
· FOM, BOE, HF, 03+Nano Spray, DSP, SC-1, IPA/N2 Dry
Specifications
· 4 FOUP In/Out Port
· 12 Chamber, 2 Buffer Station, 2 Layer (Linear Moving WTR)
· Index Robot : Multi Blade (4+1), WTR : Dual Blade
· An Independent Chamber : 1Ch 1PC, 4Aixs nozzle
Features
· Compact Design for Footprint
· Throughput Maximizing Mechanism 460 WPH
· @19m Particle Removal Performance